Technology for Semiconductor & Disply Equipment Solution
- Home >
- Products >
- System
Products
System
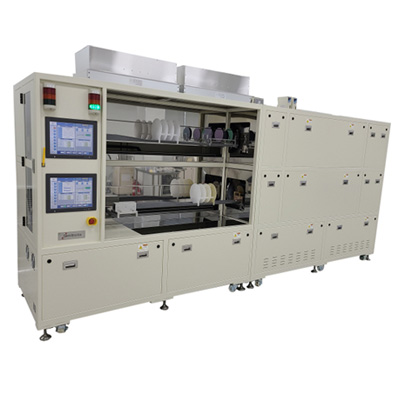
- - Wafer Size : 150mm(6") / 200mm(8")
- Type : Horizontal Furance
- Model : WAHF-6,8 Series
- Low cost, High Performance
- Proccess selectable chamber options available in 2 or 3,4 stack 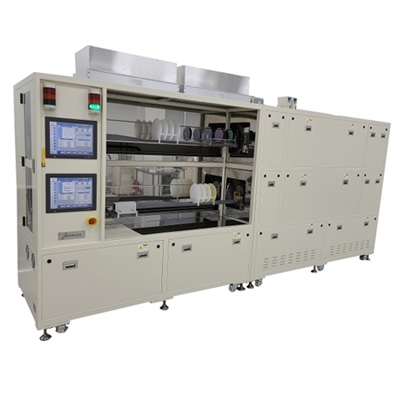
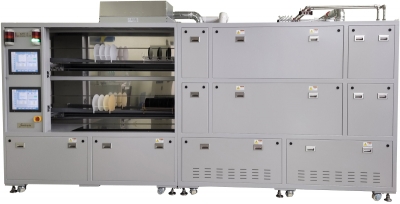


150 mm / 200 mm Horizontal Furnace
Description

▶ Specifications
Description | Contents | Remarks | |||||||||||||||||||||
Application Process | ■ Atmospheric Processes - Wet, Dry Oxidation - Thick Oxide (15um) - SiC Oxidation - Well Drive in - H2,N2 Annealing - POCL3 Doping - BBr3,B2H6 Doping
■ LP-CVD Processes - Poly Si - D-Poly Si - Nitride : Si3N4 - Low stress Nitride (250MPa) - Super Low stress Nitride (Free ~ 50MPa) - Oxide - LTO, MTO, HTO, TEOS - Thick Oxide : TEOS (2um↑ ) - SiC |
| |||||||||||||||||||||
Temperature Control Range | - 200℃ ~ 1250℃ (SiC Tube Option) - 1300℃ ~ 1350℃ |
| |||||||||||||||||||||
Temperature Control Zone | - 3 zone (4,5 zone option) |
| |||||||||||||||||||||
Temperature Accuracy | - ±1℃ at 200℃ ~ 400℃ - ±0.5℃ at 500℃ ~ 1250℃ |
| |||||||||||||||||||||
Uniformity of film thickness | - Wafer within : <2% - Wafer to Wafer : <3% - Run to Run : <3% |
| |||||||||||||||||||||
| Possible Process gases | - H2, Ar, O2, N2O, N2, SiH4, NH3, B2H6, PH3, SiH2Cl2, TEOS, BTBAS | ||||||||||||||||||||||
| Wafer Size | - 150mm / 200mm | ||||||||||||||||||||||
Process Capacity | - 50 / 100 / 150 Wafers |
| |||||||||||||||||||||
Robot Type | - Soft Landing Type (2 Axis) |
| |||||||||||||||||||||
Controller Type | - PLC base PC Control (Windows 10 compatibility) |
| |||||||||||||||||||||
| Dimension (W*D*H) | - 150mm : 4000 x 950 x 1950mm (2 Stack) - 200mm : 4500 x 1000 x 2100mm (2 Stack) | ||||||||||||||||||||||
| Power supply | - 3 Phase 380V, 100A (system will be modified to country-specific power supply) | ||||||||||||||||||||||
| Cooling water | - Max. 10 LPM / Tube | ||||||||||||||||||||||
| Compressed Dry Air | - 500 KPa | ||||||||||||||||||||||
| Heat Exhaust | - 150 m3/h |
 ENG
ENG
